熱門(mén)關鍵詞: 高低(dī)溫試驗箱 恒溫恒濕試驗箱 步入式恒溫恒濕實驗室 高壓加(jiā)速老化試驗箱 冷熱衝擊試驗(yàn)箱
某產品客戶端失效,經測試發現為電阻開路所致。電阻規格:348KΩ±0.1%,額定功率:0.1W。電阻命名如表1。

先用實體(tǐ)顯微鏡對電阻保護層進行外觀觀察,如圖(tú)1紅色框起處,A-NG陶瓷基體外露,保護層未覆蓋至邊緣。再用SEM(Hitachi S-3400N)對A-NG、A-OK邊緣保護層形貌進行放大觀察,如圖1a、1b所示,A-NG保(bǎo)護層邊緣疏鬆粗糙。
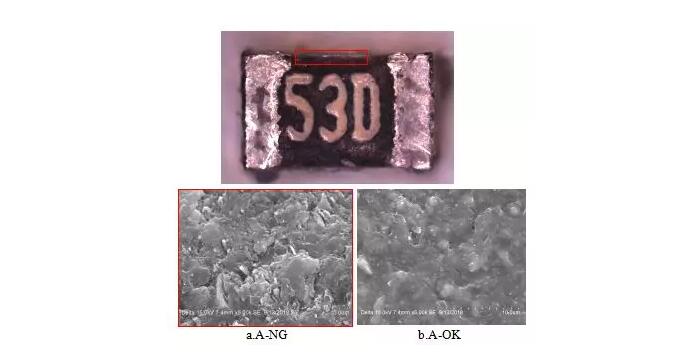
先用有機溶(róng)劑去除電阻保護層,再用金相顯微鏡進(jìn)行(háng)觀察。如(rú)圖2a黃框所示,A-NG邊緣位置金屬膜缺失,用萬用表對缺失膜兩端進行電性(xìng)確認(rèn)顯示開路,故電阻失效的原因為金屬膜缺失所致(zhì)。如圖2b所示,A-OK金屬膜完整,未見明(míng)顯異常。
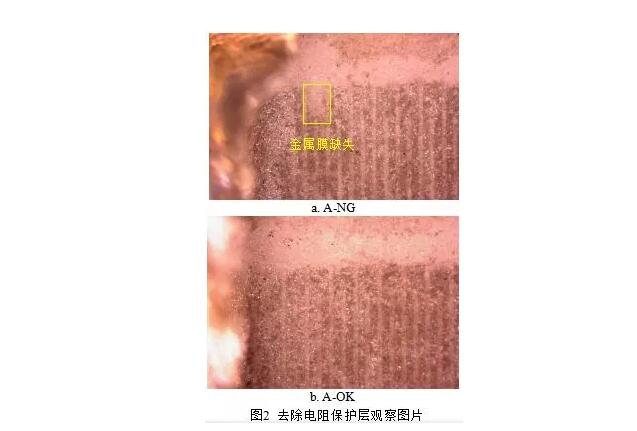
試驗條件及結果(guǒ)見表2,EOS、HAST試驗後電阻均出現阻值偏大或開路的現象。

圖3為試驗不良品去除(chú)保護層圖片(piàn),如圖3a、3b所(suǒ)示,EOS試驗不良品金屬膜均有不同程度的熔損,電壓越大膜熔損越嚴重,阻值(zhí)變化越大甚至開路(lù),此現象與A-NG金屬膜缺失現象不同。如圖3c所示,HAST試驗(yàn)不良品可(kě)見電阻邊緣位置金(jīn)屬膜缺失,與A-NG失效現象一致(zhì),失效機理為電阻在高溫、高濕、直流負荷的作用下(xià)發生電(diàn)蝕。
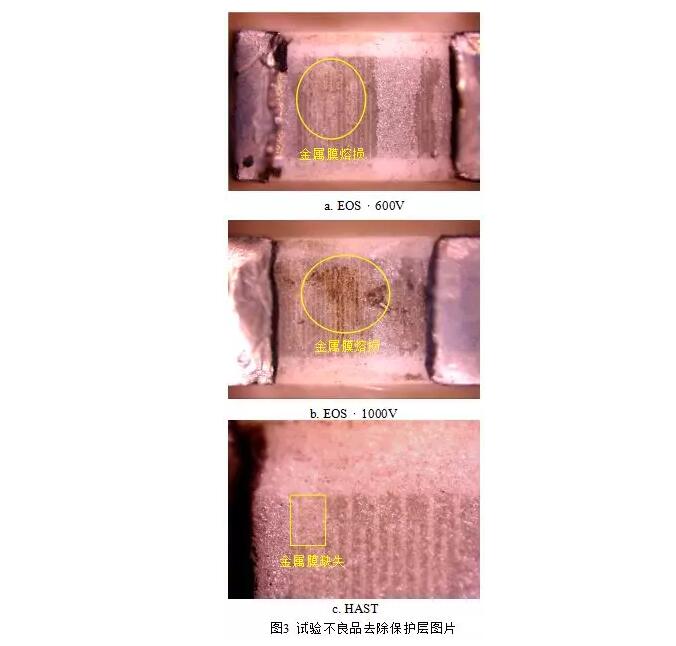
(1)在金屬膜沉積後,印(yìn)刷保(bǎo)護層之前這段時間有雜質汙染,成品通電時造成(chéng)電(diàn)蝕。
(2)保護層有外(wài)傷或覆蓋不好,雜質和(hé)水(shuǐ)汽進入導致電(diàn)蝕。為進一(yī)步研究失效(xiào)機理,尋求改善方向,對以上(shàng)2種失效機(jī)理進行深入探討(tǎo),選取A-原材、B-原材進行結構分析與比對。圖4為電阻的結構圖,電(diàn)阻的金屬膜是以Ni-Cr合金濺(jiàn)鍍沉積而成(chéng)的薄膜,基板為氧化鋁,保護層材料為(wéi)環氧(yǎng)樹脂。
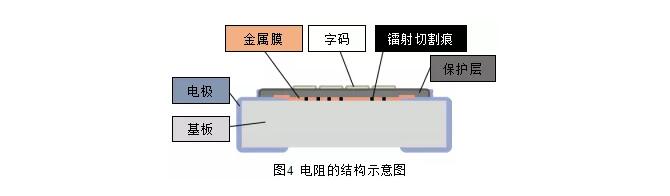
當陶瓷基體(tǐ)及金屬膜中含有K+、Na+、Ca2+、Cl-等雜質時,電解(jiě)作用加快,阻值迅(xùn)速增加,失效速度加快。為驗(yàn)證A-NG金屬膜表麵有無雜(zá)質汙染,對去除保護層後的金屬膜進行EDX(HORIBA EX-250)成(chéng)分分析,如圖5a、5b分別(bié)為缺失膜與正常膜區域的元素檢測結果,後者可見金屬(shǔ)膜Ni、Cr元素,未發現K+、Na+、Ca2+、Cl-等雜(zá)質元素,排除金屬膜表麵雜質汙染導致電蝕的猜測。
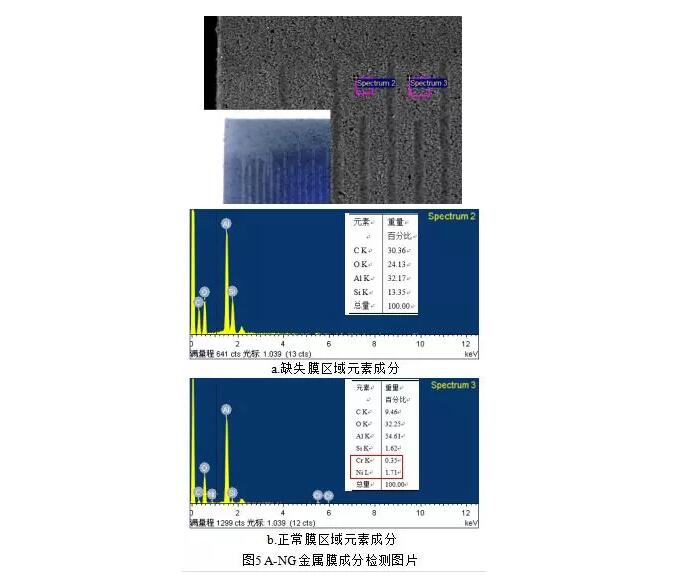
用SEM對A-原材、B-原材保護層形貌(mào)進行觀察,如(rú)圖6a紅色箭頭所示,A-原(yuán)材保護層表麵有大量孔洞。如圖6b所示,B-原材(cái)保護層表麵均勻致密。
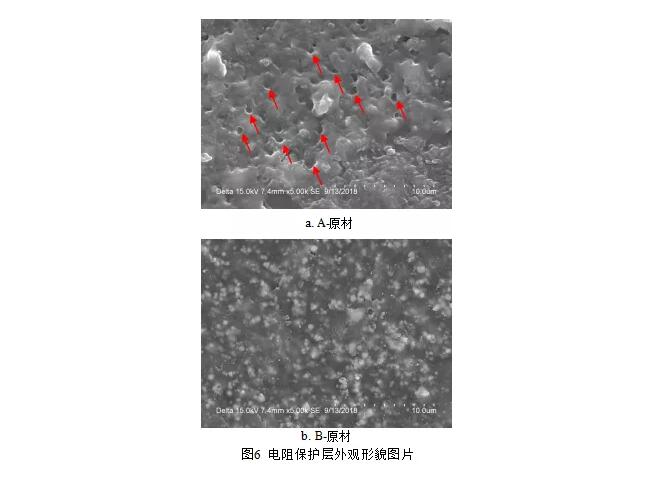
金屬膜缺失位於邊(biān)緣位置,對電阻去除(chú)正麵端電極後觀察其邊(biān)緣結構。如圖(tú)7a紅色框所示,A-原(yuán)材邊緣陶瓷基(jī)材外露。比對可知:A-原材、B-原材保護層邊緣結構設計不同,後者邊緣保護更(gèng)充分。
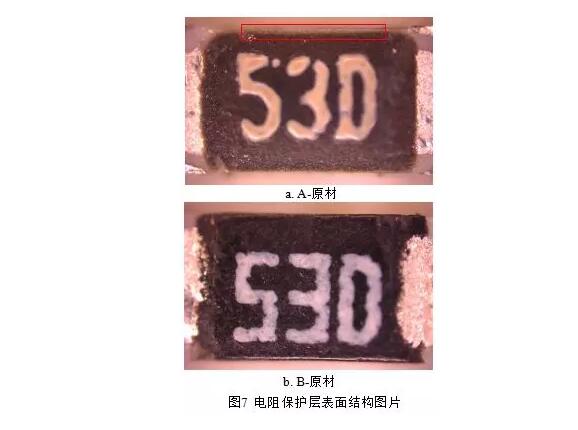
對電阻進行微(wēi)切片製(zhì)樣,用(yòng)SEM觀察保(bǎo)護層(céng)內(nèi)部微(wēi)觀結構(gòu),再進行EDS成分分析。如圖8a,A-原材保護層中間與兩(liǎng)端厚度差異明顯,中間局部可達62.64um,兩端厚度在(zài)10.58um~19.19um之間,內部填充物(wù)顆粒粗大,其主(zhǔ)要成(chéng)份為C、O、Mg、Si。如圖8b,B-原(yuán)材保護層相對(duì)較(jiào)薄,中間與(yǔ)兩端無明顯差(chà)異,厚度約為32.75um,可見不同組分的兩層結構,填充物顆粒細小,其主要成份分別為C、O、Al、Si和C、O、Mg、Al、Si、Cr、Mn、Cu。比對(duì)可知:A-原材保護層邊緣薄,且填充顆粒粗大(dà),水(shuǐ)汽易侵入,與(yǔ)失(shī)效(xiào)發生在邊緣(yuán)位置的現象相符(fú)。B-原材保護層(céng)結構致(zhì)密,且兩層結構可更好的保護金屬膜免遭濕氣的侵入。
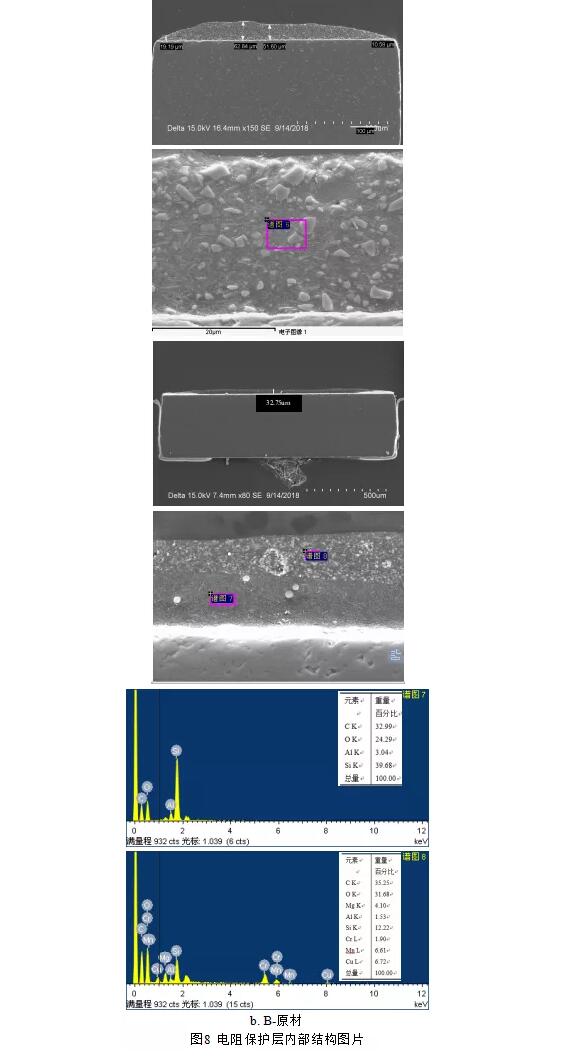
選取A-原材、B-原材各10pcs進行HAST試驗,比對不同廠商電阻耐濕熱能力。把電阻焊接在測試板上,然後(hòu)插入HAST試驗箱,設置條件:130℃/85%RH/

4) 對比A、B廠商電(diàn)阻,A廠商電阻保護層存在空洞及邊緣保(bǎo)護(hù)不到位等缺陷,容易被濕氣侵入。通過HAST比對電阻耐濕熱能力,進一步印證(zhèng)以上結論。為有效(xiào)的提高電阻的耐濕熱性能,建議(yì)從電阻保護層的工藝、厚度以及材質方麵加(jiā)以改善:a.選擇填充顆粒細小的(de)材(cái)料(liào),減少濕氣進入通道;b.調整保(bǎo)護(hù)層的厚度,使中(zhōng)間與邊緣(yuán)厚度相對均(jun1)勻(yún);c.使用耐濕(shī)熱的保護材(cái)料。
文章來源:江蘇中達電子
本(běn)文標簽: HAST試驗(yàn) HAST高壓加速老化試驗箱 貼片薄膜電阻失效 HAST
溫濕(shī)度試驗箱 新聞資訊 產品 關於草莓视频网站 解決方(fāng)案 聯係草莓视频网站 合作案(àn)例 網站地圖
400電話