熱門(mén)關鍵詞(cí): 高(gāo)低溫試驗箱 恒溫恒濕試驗箱(xiāng) 步入式恒(héng)溫恒濕實(shí)驗室 高壓加速老化試驗箱 冷熱(rè)衝擊試驗箱
近幾年來,本實驗室連續開展了大規模集成電(diàn)路的新品檢測工作,如偵察運算電路、BCH編譯碼器(qì)、CRT地址(zhǐ)產生電路及(jí)接口電路等,基本上都是規模較大的CMOS電路,對靜電敏感,工作速度較快。在(zài)高(gāo)、低溫電性能測(cè)試(shì)中成功地(dì)采用了該(gāi)集成電路高、低(dī)溫電性能測試係統,積(jī)累了一些有益的(de)經驗。通過實際應用發現,必須注意以下(xià)一些具體的環節,如測試板(bǎn)的隔離、防(fáng)潮,被測器件的靜電保護,被測器件芯片溫度的確定等問題,才能(néng)快速、準確地(dì)完成CMOS VLSI的高、低溫電(diàn)性能(néng)測試。
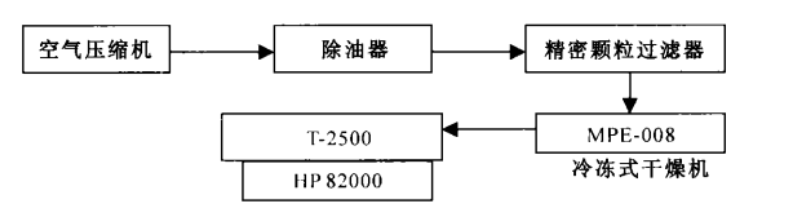
在用該高、低溫測試係統做溫度測試時,係統(tǒng)有溫度傳感器叮測到器件底(dǐ)部的溫度,雖然氣(qì)流是重直於(yú)DUT表麵(miàn)而下,但DUT的底部還是屬於器件表(biǎo)麵,如何確定DUT芯片溫度的建立時間,是個比較複(fù)雜的問題(tí)。因為DUT芯片(piàn)溫(wēn)度的建立時(shí)間受很(hěn)多因(yīn)係的影響,如DUT的材料、形狀尺寸,溫(wēn)度以及氣體(tǐ)流量的大小等因素的影響。不同的器件芯(xīn)片溫度的建立時間是不一樣的,溫度建立時間是指係統變溫( 升溫獲降溫)開始,到建立新的熱平衡,即被測器件芯片溫度達到設定值這一段時間。某(mǒu)公司給出了1000Ω電阻溫度探測器(RTD)的溫度建立(lì)時間(jiān)曲線,如圖3所示。圖3表明不同的RTD其溫度(dù)建立時間是不同(tóng)的。
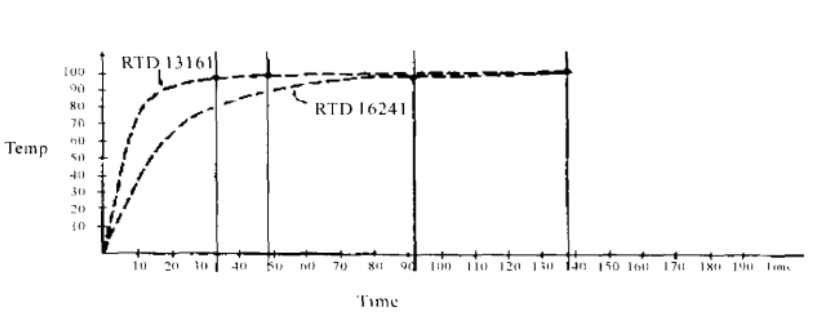
DUT芯片溫度的建立時間對於高、低溫測試是非(fēi)常重要的指標,隻(zhī)有(yǒu)在大於建立時間(jiān)的時間段(duàn)內測試,測試的數據才能真正(zhèng)地(dì)反映設定溫度點的性能及具有重複性。對於複雜的大規模集成電路,我們采取在開始高、低溫測試前,通過反複試驗,確定被測器件芯片溫度的建立時間。在熱流係統顯示(shì)達到設定(dìng)溫度(dù)開始,對被測器件進行多次(cì)電參數測試,當其電參數(shù)趨於穩定並具(jù)有可重複性時,將這段時間確定為DUT芯片溫度的建立時間。經過反複試驗發現(xiàn),係統的溫度傳感器測得的被測器件底部溫度與芯片溫度基本一致。
400電話