晶圓級(jí)芯片(piàn)可靠性(xìng)測試後高電阻值異常如何詢失效點?
作者:
網絡
編輯:
網絡
來源:
www.tuyatang.com
發(fā)布日期: 2020.07.08
所謂的WLCSP晶圓級芯片尺寸封裝,全名Wafer Level Chip Scale Packaging,是指,直接將整片晶圓級封裝製程完(wán)後,再進行切(qiē)割,切完後(hòu)封裝體的尺寸等於原(yuán)來(lái)晶粒的大小,後續(xù)利用(yòng)重分布層(RDL),可直接將I/O拉出陣列錫球與PCB做連接。
也因隨著(zhe)輕薄(báo)短小的需求,WLCSP成為(wéi)封裝形式的(de)主流,在WLCSP的封裝體概念下(xià)衍生出Fan-in,Fan-out與Info等晶圓級(jí)封裝體。然而,此類封裝形式,在可靠度驗證後,常(cháng)見的失效模式,如錫球界(jiè)麵、吃錫不良,上板後應力匹配問題。
所以,當要確認WLCSP形式的元件,在可靠度驗證後的失效點時,就更需要留意分析工具的時機點是否會有應力產生,免得反而破壞掉「命案現場」(原有的(de)失效點),導致更難確認失效真因。
以下這個案例(lì),小編提出三步驟,告訴你失效分析工具該(gāi)如何選擇?特別是什麽時機點,命案現場才能夠清除,快速讓失效(xiào)點(defect)無所遁形。輕易找到失效真因。
步驟 : 定位
針對可靠度實驗後(hòu)產生(shēng)高阻的WLCSP元件,利(lì)用Thermal EMMI故障點熱輻射傳導的相位差(chà),定位到失效位置,是在Solder
Ball 地方(fāng)。
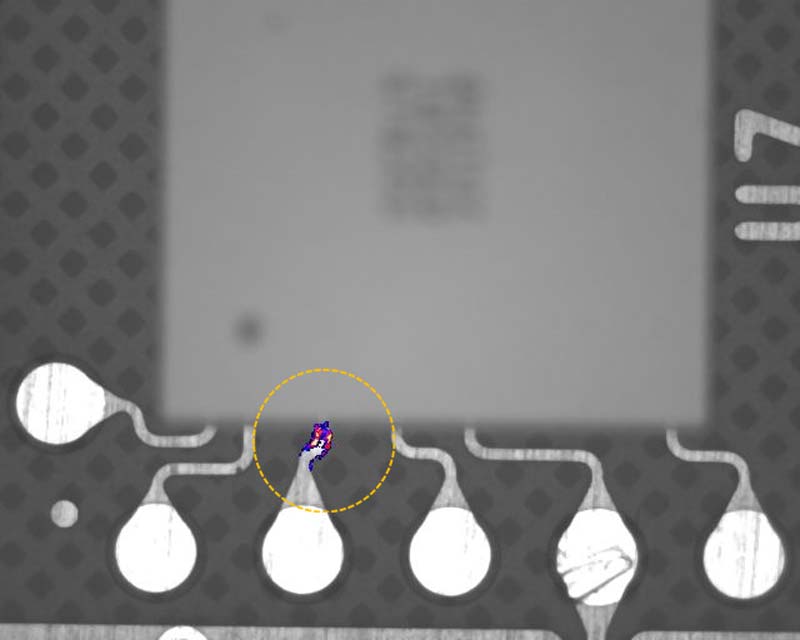
第二(èr)步驟 : 顯像
接著,為了不破壞「命案現場」,因此使用3D X-ray進(jìn)行立體圖(左下圖)與斷麵圖(右下圖)顯像,找到原來是錫球(Solder Ball)有損毀(huǐ)狀況。
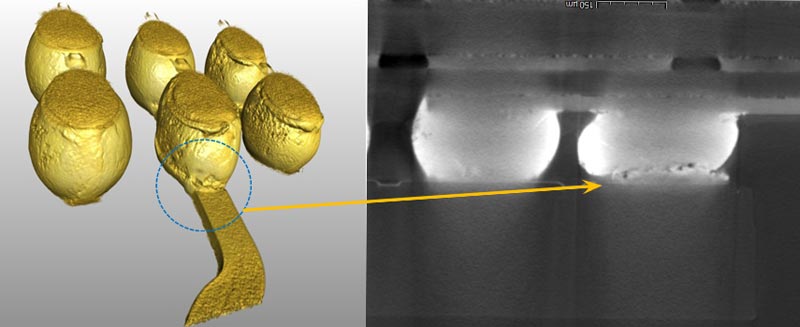
第三步驟 : 切片
在已確認Defect相對位置時(shí),此時即可移除「命案現場」,使用(yòng)低(dī)應(yīng)力Plasma FIB工具,將失效斷麵切出並分析真(zhēn)因,找到原(yuán)來是Solder Ball Crack狀況,導致元件高阻值異常而失效。