適用範圍:
該試驗檢查(chá)芯片長期貯存條件(jiàn)下,高溫和時間對器件的影響(xiǎng)。本規範適用(yòng)於量產芯片驗證測試階段(duàn)的HAST測試需求(qiú),僅針對非(fēi)密封封裝(塑料封裝),帶偏置(bHAST)和不帶偏置(uHAST)的測試。簡介(jiè):
該試驗(yàn)通過溫度、濕度、大氣壓力加速條件,評估非密封封(fēng)裝器件在上電狀態下,在高溫、高壓、潮濕環境中的可(kě)靠性。它采(cǎi)用了嚴格的溫度,濕度,大氣壓(yā)、電壓條件,該條件會加速水分滲透到材料內部與金屬導體之間的電化學反應。引用文件:
下列文(wén)件中的條(tiáo)款通過本(běn)規範的引(yǐn)用而成為本(běn)規範的條款。凡是注日期的引用文件,其隨後(hòu)所有的修改單(不包括勘誤(wù)的內容(róng))或修訂版均不適用於本規(guī)範,然而,鼓勵根據本規範達成協議的各方研究是否可使用這些文件的新版本。凡是(shì)不注日期的引用文件,其(qí)新版本適用於本規範。

1. HAST測試流程
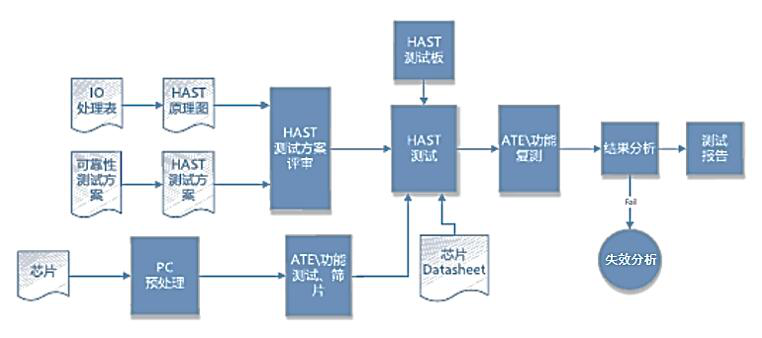
2.1 溫(wēn)度、濕度、氣壓(yā)、測試時間 HAST試驗條件如下表所示:

➢ 測試(shì)過程中,建議調試階段監(jiān)控芯(xīn)片殼溫、功耗數據推算芯片(piàn)結(jié)溫,要保證結溫不能(néng)過 高,並在(zài)測試過程中定期(qī)記錄。結溫(wēn)推算(suàn)方法(fǎ)參考《HTOL測試(shì)技術規範》。
➢ 如果殼溫與環溫差值或者功(gōng)耗滿足下表三種關係時,特(tè)別是當殼溫與環溫差值超過 10℃時,需考(kǎo)慮周期性的電壓拉偏策略。

2.2 電壓拉偏
uHAST測試(shì)不帶電壓(yā)拉偏,不需要關注該節(jiē);
bHAST需要帶電壓拉偏,遵循以下原則:
(1) 所有電源上電,電壓:推薦操作範圍電壓(Maximum Recommended Operating Conditions)
(2) 芯(xīn)片功耗(hào)小(數字部分不翻轉、輸入晶(jīng)振短接(jiē)、其他降功耗(hào)方法);
(3) 輸入管(guǎn)腳在(zài)輸入電壓允許範圍內拉高。
(4) 其他管腳,如時鍾端、複位端、輸出管腳在輸出範圍內隨機拉高或者(zhě)拉低;
2.3 樣本量

➢ 高(gāo)溫、高壓、濕度控製試驗箱(HAST高壓加速老化試驗箱)——溫度(dù)、濕度、氣壓強度範圍可控,測試時間可控。
4. 失效判據
➢ ATE\功能篩片有功能失效、性(xìng)能異(yì)常。
5. HAST測試注意事項
➢ 測試過程要求(qiú)每(měi)天記錄電源電壓、電流、環境溫度、殼溫(推算結溫)等(děng)關鍵數據。
➢ 注意芯片內部模擬電路是否有上電默認開啟的(de)模塊,這樣的模塊會導致靜態電流太大,引起其他機製的失效。
➢ 調(diào)試過程注意,考慮到較大的電流引起壓(yā)降,電壓等的記錄應該是到板電壓,而不是電源源端(duān)電壓。
➢ 調試過程注意,室溫條(tiáo)件下的電源電壓與規定要求下的(de)電源電壓不同,可以(yǐ)在室溫下初調,待試驗環境到達HAST設定條件後做終調(diào)試(shì)。








